С быстрым развитием электронных устройств в направлении миниатюризации, многофункциональности, высокой энергопотребления и повышенной надежности появилась технология высокоплотной трехмерной интеграции для микроэлектронных устройств. Однако развитие высокоплотной интеграции сдерживается повышенными температурами перехода, вызванными тепловой концентрацией внутри микросхем, что значительно ухудшает производительность и надежность устройств.
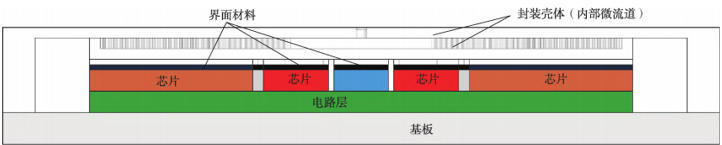
Интегрированные чипы имеют многослойную структуру, состоящую из подложки, слоев схем чипов, чипов и охлаждающих пластин корпуса. Охлаждающая пластина корпуса содержит микроканалы, которые отводят тепло от чипов слоя схем посредством конвективного теплопереноса жидкости, обеспечивая при этом равномерное распределение температуры чипов. Гибкие теплопроводящие материалы (TIM) соединяют интерфейс между охлаждающей пластиной корпуса и слоем схем.
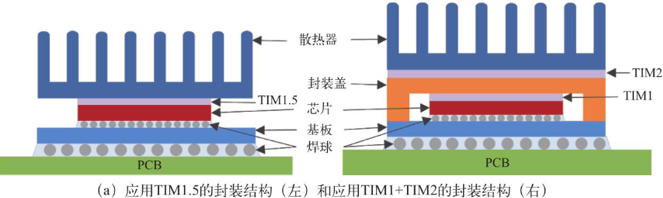
Термоинтерфейсные материалы (TIM) являются важными компонентами для отвода тепла, которые заполняют микроскопические зазоры между поверхностями, непосредственно улучшая тепловые характеристики. TIM обычно наносятся между чипом и крышкой корпуса (TIM1), чипом и радиатором (TIM1.5) и крышкой корпуса и радиатором (TIM2). Высокая теплопроводность и надежность TIM обеспечивают быструю передачу тепла через интерфейсы. Преобладающий подход к управлению тепловым режимом для чипов с высокой вычислительной мощностью по-прежнему основан на использовании материалов TIM1 с ультранизким тепловым сопротивлением для быстрого отвода тепла из внутренней части чипа к корпусу корпуса. Затем тепло передается через материалы TIM2 к жидкостной охлаждающей пластине, которая быстро рассеивает его во внешнюю среду за счет быстрого потока внутренней охлаждающей жидкости.

Кроме того, технологии низкотемпературного соединения получили широкое применение в процессах упаковки. Например, низкотемпературное соединение Cu-Cu стало основной технологией в современной упаковке благодаря своим преимуществам в высокоплотных соединениях и превосходной электрической и тепловой проводимости. Процесс спекания нано-серебра является примером технологии низкотемпературного соединения. Он формирует соединительные интерфейсы с высокой теплопроводностью (250 Вт/(м·К)) при низких температурах (250 °C), эффективно предотвращая тепловое повреждение, связанное с традиционными высокотемпературными процессами. Полученные соединительные структуры обладают чрезвычайно низкой пористостью, превосходной теплопроводностью и исключительной механической стабильностью, что обеспечивает надежную гарантию для современной упаковки.